华硕在无数次泄密之后,终于推出了 ROG Phone 6D 和 6D Ultimate 游戏旗舰智能手机。 这些是以前版本的 ROG Phone 6 的类似物......
最新的 AMD 3D V-Cache 技术使用 9 微米微链接

在 Hot Chips 33 上,AMD 推出了其 3D V-Cache 解决方案,这应该是其 Zen 处理器及其他产品开发的里程碑。
AMD 的介绍让我们回顾了所有允许您构建集成电路的此类技术。 目前,在处理器或内存模块中独立连接各个层的最流行方法是 TSV(硅通孔)。 这是一种使用微连接(桥)连接各个层的方法,其数量决定了传输速度及其稳定性。
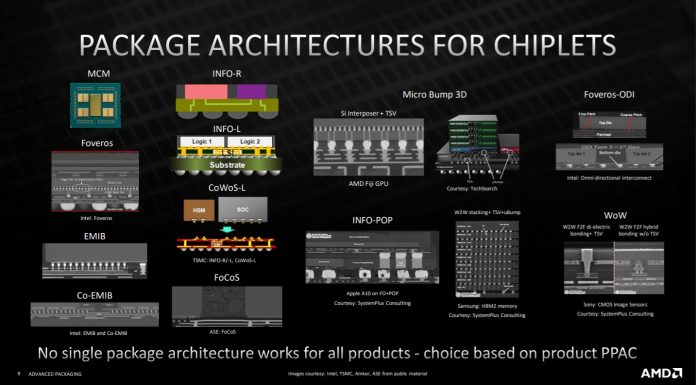
AMD 的 TSV 连接解决方案是使用 9 微米间距与英特尔基于 10 微米间距的 Foveros Direct 技术竞争。
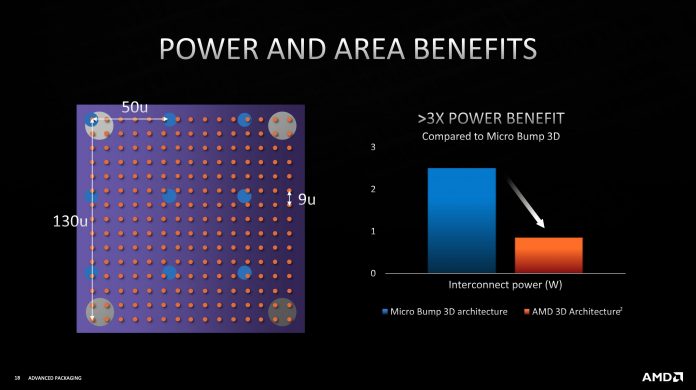
AMD 预测,他们最新的 3D Chiplet 技术使用 9 微米互连,能效提高 3 倍,密度提高 XNUMX 倍。
受益于这种半导体堆叠的第一批处理器将是使用 Zen3 架构的 AMD 处理器,即 AMD Ryzen 9 5900X,它应该获得 3MB 更大的三级缓存。
这篇文章有帮助吗?







