A mais recente tecnologia AMD 3D V-Cache usa microlinks de 9 mícrons

No Hot Chips 33, a AMD apresentou sua solução 3D V-Cache, que deve ser um marco no desenvolvimento de seus processadores Zen e além.
A apresentação da AMD nos permitiu relembrar todas as tecnologias desse tipo que permitem construir circuitos integrados. Atualmente, a maneira mais popular de conectar independentemente camadas individuais em processadores ou módulos de memória é o TSV (Through Silicon Via). Este é um método de conectar camadas individuais usando microconexões (pontes), cujo número determina a velocidade de transmissão e sua estabilidade.
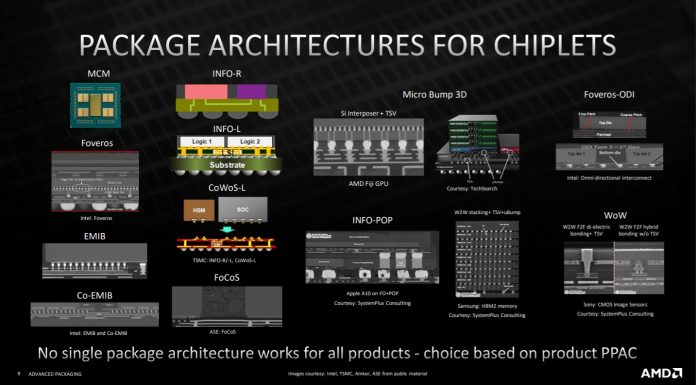
A solução da AMD para interconexões TSV é usar interconexões de 9 mícrons, destinadas a competir com a técnica Foveros Direct da Intel, que é baseada em interconexões de 10 mícrons.
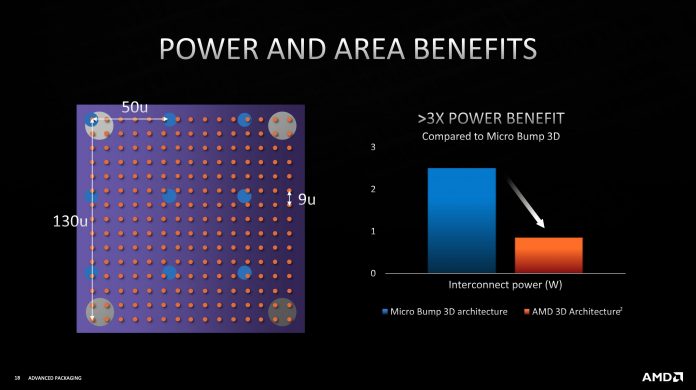
A AMD prevê que sua mais recente tecnologia Chiplet 3D, usando interconexões de 9 mícrons, será 3 vezes mais eficiente em termos de energia e quinze vezes mais densa.
Os primeiros processadores a se beneficiarem desse tipo de empilhamento de semicondutores serão os processadores AMD usando a arquitetura Zen3, ou seja, o AMD Ryzen 9 5900X, que deve receber um cache L3 64 MB maior.







