L'ultima tecnologia AMD 3D V-Cache utilizza micro link da 9 micron

A Hot Chips 33, AMD ha presentato la sua soluzione 3D V-Cache, che dovrebbe essere una pietra miliare nello sviluppo dei suoi processori Zen e oltre.
La presentazione di AMD ci ha permesso di richiamare tutte le tecnologie di questo tipo che consentono di costruire circuiti integrati. Attualmente, il modo più diffuso per collegare in modo indipendente i singoli livelli in processori o moduli di memoria è TSV (Through Silicon Via). Questo è un metodo per collegare i singoli strati mediante microconnessioni (ponti), il cui numero determina la velocità di trasmissione e la sua stabilità.
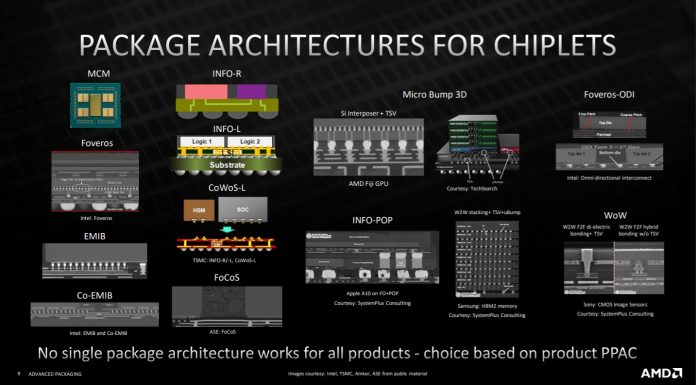
La soluzione di AMD per le interconnessioni TSV consiste nell'utilizzare interconnessioni da 9 micron, destinate a competere con la tecnica Foveros Direct di Intel, che si basa su interconnessioni da 10 micron.
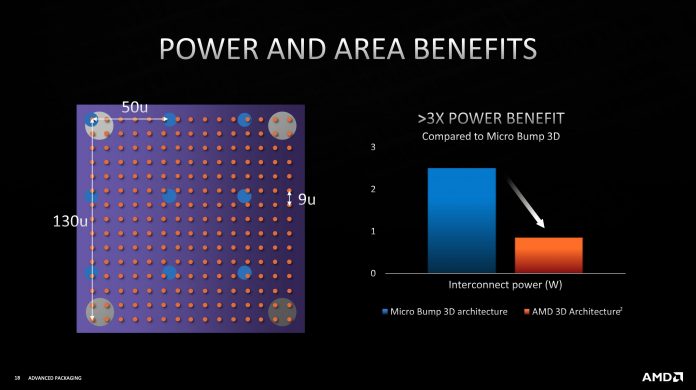
AMD prevede che la loro ultima tecnologia Chiplet 3D, che utilizza interconnessioni da 9 micron, sarà 3 volte più efficiente dal punto di vista energetico e quindici volte più densa.
I primi processori a beneficiare di questo tipo di stacking dei semiconduttori saranno i processori AMD che utilizzano l'architettura Zen3, ovvero l'AMD Ryzen 9 5900X, che dovrebbe ottenere una cache L3 più grande di 64 MB.







