La dernière technologie AMD 3D V-Cache utilise des micro-liens de 9 microns

Lors du Hot Chips 33, AMD a dévoilé sa solution 3D V-Cache, qui devrait être une étape importante dans le développement de leurs processeurs Zen et au-delà.
La présentation d'AMD nous a permis de rappeler toutes les technologies de ce type qui permettent de construire des circuits intégrés. Actuellement, le moyen le plus populaire de connecter indépendamment des couches individuelles dans des processeurs ou des modules de mémoire est TSV (Through Silicon Via). Il s'agit d'une méthode de connexion de couches individuelles à l'aide de micro-connexions (ponts), dont le nombre détermine la vitesse de transmission et sa stabilité.
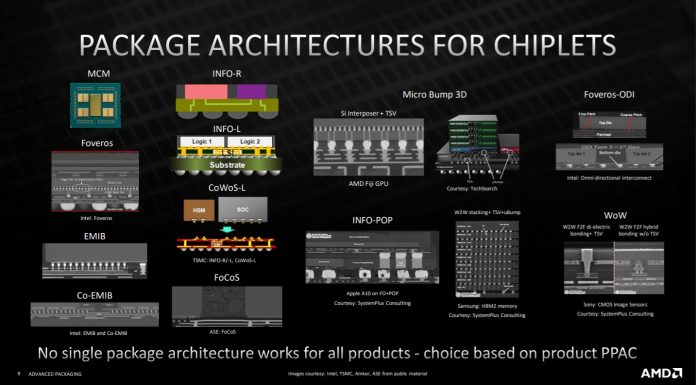
La solution d'AMD pour les connexions TSV consiste à utiliser un espacement de 9 microns pour concurrencer la technique Foveros Direct d'Intel basée sur un espacement de 10 microns.
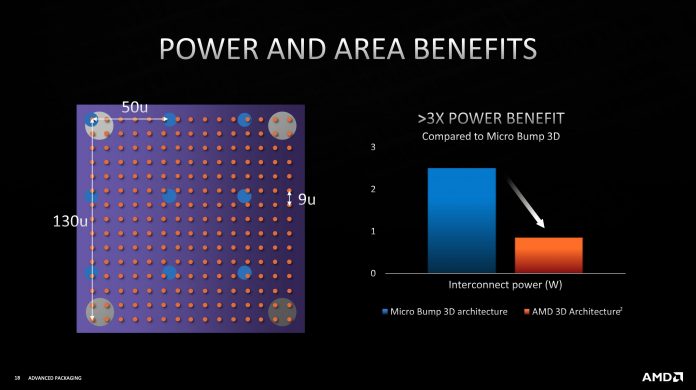
AMD prévoit que sa dernière technologie 3D Chiplet, utilisant des interconnexions de 9 microns, sera 3 fois plus économe en énergie et XNUMX fois plus dense.
Les premiers processeurs à bénéficier de ce type d'empilement de semi-conducteurs seront les processeurs AMD utilisant l'architecture Zen3, à savoir l'AMD Ryzen 9 5900X, qui devrait bénéficier d'un cache L3 plus grand de 64 Mo.







